2. 材料物理教育部重点实验室 河南 郑州 450001
2. Key Laboratory of Materials Physics of Ministry of Education, Zhengzhou 450001, China
作为第三代半导体的典型材料,GaN是一种直接带隙半导体,具有带隙宽、载流子迁移率高、热导率高、化学稳定性和热稳定性好等优势[1],已广泛应用于制备各种光电子器件,如太阳能电池、光电探测器、发光二极管、激光二极管和高电子迁移率晶体管等[2-6]。为获得高性能的GaN器件,制备高质量GaN薄膜至关重要。在过去几十年的研究中,许多传统的薄膜制备技术,包括化学气相沉积[7]、金属有机化学气相沉积[8]、氢化物气相外延[9]、分子束外延[10]等,都被用于制备同质外延和异质外延GaN薄膜。由于GaN与衬底材料之间晶格常数和热膨胀系数不同而存在晶格失配和热失配,这些方法在生长GaN薄膜的过程中,都不可避免地引入各种缺陷。
GaN中的缺陷可以分为点缺陷和扩展缺陷,其中点缺陷包括空位、间隙、反位、杂质、复合缺陷,扩展缺陷包括位错、团簇等。在GaN薄膜外延生长的过程中,常见的点缺陷为镓空位(VGa)、氮空位(VN)、双空位(VGaVN)。在富镓制备条件下,VGa的形成能较低,2-/3-、-/2-和0/-跃迁能级的能量分别为1.10 eV、0.64 eV和0.25 eV,此外,VGa在较宽的温度范围内可以移动,通常能在生长或热退火过程中迁移并形成更稳定的复合缺陷。当费米能级接近导带时,n型GaN中VGa的形成能较低,作为一种类受主缺陷,VGa起补偿中心作用。VN的能级靠近或在导带中,第一性原理计算表明,只有在富镓条件下,n型GaN中才能形成可检测浓度的VN,VN在带隙中只有一个跃迁能级,即位于价带上方(0.5±0.2) eV的3+/+态。双空位VGaVN在GaN中具有较高的形成能,不容易形成。GaN晶格常数小,Ga原子和N原子尺寸失配大,因此在GaN中形成间隙缺陷和反位缺陷的概率很低。但在某些条件下,有些缺陷可能会形成。在室温下,镓间隙(Gai)具有高迁移率,意味着Gai被其他缺陷所束缚,在GaN中不能作为孤立缺陷存在。氮间隙(Ni)形成N-N带,在富镓条件下需要较高的形成能,在带隙中可以形成与不同电荷态Ni相对应的4个稳定能级,Ni的迁移势垒为1.5 eV,因此当略高于室温时,Ni可以在GaN中形成并扩散。镓反位(GaN)在GaN中引入深能级,GaN的4+/3+能级约在价带上方0.9 eV。氮反位(NGa)在GaN的带隙中引入3到4个深能级,它既可以作为p型GaN的施主,也可以作为n型GaN的受主,无论费米能级的位置如何,NGa的形成能都很高,特别是在富镓条件下,中性NGa缺陷为亚稳态。在立方GaN中,中性NGa缺陷很有可能转变为VGaNi缺陷[11]。因此,在富镓制备条件下,最容易形成的点缺陷为VGa、Ni。扩展缺陷通常对发光没有贡献,但能通过俘获载流子或吸收点缺陷影响材料的光电性能。
点缺陷和扩展缺陷都会对器件产生极大的危害。在探测器中,这些缺陷使暗电流和噪音增大,响应度降低;在发光器件中,这些缺陷会降低辐射效率和使用寿命。此外,点缺陷和它们形成的复合缺陷会产生寄生电流,特别在低频电子器件中,会减少电子设备的增益,增大噪音;在激光器中会影响激光器的阈值电流、效率和使用寿命,并造成场效应晶体管不稳定[12]。因此,若能通过优化实验方案,减少GaN中缺陷种类和数量,这将对GaN基光电器件性能的提高有重大的意义。硅纳米孔柱阵列(Si-NPA)是一种新型的硅微米-纳米复合结构体系,规则的微米量级纳米孔柱阵列垂直排列,Si-NPA的孔壁中大量的纳米硅及其广泛的尺寸分布,会增加捕获光子的概率,使Si-NPA整体光吸收增加,是一种构建纳米异质结构器件的功能性衬底。此外,三维应力释放策略能在一定程度上减少GaN与衬底材料之间的晶格失配和热失配。本文选择Si-NPA作为功能性衬底,采用化学气相沉积法制备了GaN/Si-NPA异质结,并在氨气氛围中高温退火以提升GaN/Si-NPA异质结的光电性能。
1 实验过程及测试方法 1.1 实验过程在含硝酸铁的氢氟酸溶液中对单晶硅片(sc-Si)采用水热腐蚀法制备Si-NPA。将硼掺杂(111)取向的p型sc-Si(掺杂浓度为1018~1019 cm-3;电阻率为0.01 Ω/cm)切成2 cm×2 cm的方形,用聚四氟乙烯方块固定好,将方形硅片在超声中分别采用酸洗、水洗、碱洗、水洗、酸洗再水洗的方法洗去表面的有机污染物和灰尘等。取Fe(NO3)3·9H2O溶于氢氟酸和水的混合溶液中配制腐蚀液,硝酸铁浓度为0.04 mol/L,氢氟酸溶液浓度为13 mol/L,将洗净的sc-Si放入盛腐蚀液的反应釜中,并将反应釜放入高鼓风干燥箱,加热温度设为140 ℃,加热40 min后自然冷却至室温,用去离子水清洗表面的残留溶液。至此,Si-NPA衬底制备完成。
采用真空离子溅射法在Si-NPA表面溅射一层5 nm的金属铂作为GaN生长的催化剂,采用化学气相沉积法在Si-NPA衬底上生长GaN薄膜。把Si-NPA放在方舟上,将纯度为99.999 9%的金属镓放入坩埚中作为GaN生长的镓源,两者相距1.0 cm,把方舟和坩埚置于管式炉的加热中心,用高纯度氩气(99.999%)洗气20 min,排出管式炉中残留空气。以10 ℃/min的升温速度将管式炉加热到950 ℃,通入流量为15 mL/min的氨气(99.999 5%),同时氩气载气的流量为150 mL/min,优化GaN的生长时间为40 min,生长过程结束后在氩气的保护作用下降至室温。对制备的GaN/Si-NPA薄膜进行氨气氛围中高温退火处理,退火温度为1 050 ℃,氨气流量为15 mL/min,氩气载气的流量为150 mL/min,退火压强为600 Pa,退火时间为3 h。退火前后的GaN/Si-NPA采用真空蒸镀法在sc-Si层蒸镀Ag电极(100 nm),采用磁控溅射法在GaN层镀氧化铟锡(ITO)作为顶电极(200 nm),形成的器件结构为ITO/n-GaN/p-Si-NPA/sc-Si/Ag,制备流程如图 1所示。
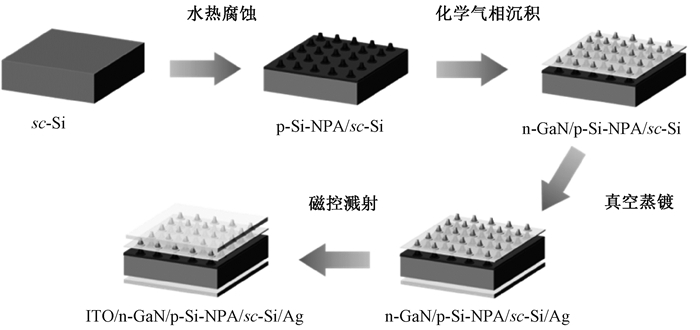
|
图 1 从sc-Si到ITO/n-GaN/p-Si-NPA/sc-Si/Ag的制备流程 Fig. 1 The preparing procedure from sc-Si to ITO/n-GaN/p-Si-NPA/sc-Si/Ag |
通过X射线衍射(XRD,Panalytical X′Pert Pro)对GaN/Si-NPA的晶体结构进行表征,采用CuKα作为射线(λ=0.154 nm)并在薄膜模式下工作;用场发射扫描电子显微镜(FE-SEM,Zeiss Auriga)观察GaN/Si-NPA的表面形貌;利用双光栅荧光光谱仪(Horiba Fluorolog-3)测试GaN/Si-NPA的光致发光谱,激发波长和狭缝宽度分别为325 nm和5 nm;在室温下,通过Keithley-2400测试GaN/Si-NPA的电流密度-电压(J-V)特性曲线。
2 实验结果与讨论 2.1 GaN/Si-NPA的晶体结构与形貌表征图 2为生长40 min的GaN/Si-NPA退火前后的XRD图谱。氨气氛围中退火前后的样品均显示出10个衍射峰,峰位分别为32.47°、34.63°、36.92°、48.17°、57.83°、63.57°、68.01°、69.22°、70.57°、73.22°,分别对应于GaN(JCPDS卡:No.00-050-0792)晶体的(100)、(002)、(101)、(102)、(110)、(103)、(200)、(112)、(201)、(004)晶面。图中没有观察到衬底Si-NPA的衍射峰,表明所沉积的GaN薄膜完全覆盖了Si-NPA衬底。氨气氛围中退火前后的GaN均具有良好的结晶性,且GaN晶体为六方纤锌矿结构。退火处理后,XRD图谱中衍射峰的半高宽减小,其中最强的(101)衍射峰半高宽从0.519°减小到0.377°。根据衍射峰的谢勒公式,平均晶粒尺寸为D=Kλ/βcos θ。其中:K为谢勒常数,取K=0.89;λ为X射线波长,约为0.154 nm;β为衍射峰的半高宽;θ为衍射角。经计算,退火前后GaN/Si-NPA的平均晶粒尺寸分别为18.9 nm和25.4 nm,表明退火后晶粒尺寸增大。

|
图 2 退火前后GaN/Si-NPA的XRD图谱 Fig. 2 The XRD patterns of as-prepared and annealed GaN/Si-NPA |
图 3为用场发射扫描电子显微镜得到的Si-NPA和GaN/Si-NPA的SEM图。从图 3(a)和图 3(b)可以看出,规则排列的硅柱垂直于衬底表面,硅柱高2.5 μm。根据文献[13]的研究结果,硅柱由纳米孔组成,平均孔径为8.2 nm,硅柱的孔壁是由SiOx包裹的、平均晶粒尺寸为3.4 nm的sc-Si颗粒组成。霍尔效应测试结果表明,Si-NPA与sc-Si具有相同的导电类型,二者均为p型。图 3(c)为退火前GaN/Si-NPA的表面形貌图,可以很明显地看出,大量的GaN晶体生长在Si-NPA衬底表面,晶体的形状不规则,典型的GaN晶粒尺寸为几百个纳米。从图 3(d)可以看出,GaN层与Si-NPA层紧密相连,形成连续致密薄膜,膜厚约为400 nm。如图 3(e)和图 3(f)所示,在氨气氛围中退火处理后,GaN/Si-NPA的形貌发生了一些明显的变化:第1个变化为形貌重建,GaN晶体趋向于Si-NPA聚集,围绕硅柱生长,形成分离的GaN/Si-NPA阵列;第2个变化为GaN晶粒尺寸的增加,由200 nm增加到300 nm;第3个变化为GaN与Si-NPA界面层的薄膜更加紧实致密,且薄膜厚度由500 nm减小到300 nm。由于纳米晶的积累,晶粒尺寸会大于由XRD计算的结果。

|
图 3 Si-NPA和GaN/Si-NPA的SEM图 Fig. 3 The SEM images of Si-NPA and GaN/Si-NPA (a)、(b)Si-NPA的平面和截面SEM图;(c)、(d)退火前GaN/Si-NPA的平面和截面SEM图;(e)、(f)退火后GaN/Si-NPA的平面和截面SEM图。 |
图 4为325 nm紫外光激发的GaN/Si-NPA的光致发光(PL)谱。如图 4(a)所示,退火处理使得GaN/Si-NPA的PL谱的峰形发生了较大变化。采用高斯分峰拟合后,可以将退火前GaN/Si-NPA的PL谱分为3个发光峰(图 4(b)),分别为384.5 nm的紫外光带、428.3 nm的蓝光带、577.1 nm的黄光带。GaN的本征发光为365 nm,激子结合能为20 meV。因此,可将该紫外光带归因于GaN的近带边辐射和激子辐射的复合发光[11, 14]。由于GaN生长过程中存在各种点缺陷,导致GaN在绿-黄-橘光谱范围内均有光致发光。本研究中,黄色发光带是一个横跨450~720 nm的宽光带,中心峰位为577.1 nm。根据对GaN光致发光机制的研究以及GaN/Si-NPA的制备工艺,黄光带的产生与点缺陷VGa(0.28~1.10 eV)、VN(0.3~0.7 eV)、Ni(0.75~2.02 eV)、SiGa(0.9 eV)或复合缺陷VGa-ON(0.7~3.5 eV)的能级有关[11, 15]。只有CGa或CN点缺陷可以产生蓝色发光带[16],鉴于GaN的制备过程没有C元素参与,因此蓝色发光带不应该产生于与缺陷相关的跃迁。在以往对Si-NPA的PL谱性能研究中,Si-NPA高温退火后的PL谱会产生蓝色发光带,因此可将该蓝光带归因于衬底Si-NPA的发光。577.1 nm的黄色发光源于GaN中VGa、Ni等本征缺陷引入的深施主能级上电子向浅受主能级或价带跃迁过程中产生的辐射复合发光[11]。这些缺陷会影响GaN/Si-NPA的电学性能,降低基于异质结的光电器件的性能。

|
图 4 325 nm紫外光激发的GaN/Si-NPA的光致发光谱 Fig. 4 Photoluminescence spectra of GaN/Si-NPA excited by 325 nm ultraviolet (a)退火前后PL谱对比;(b)退火前高斯分峰拟合谱;(c)退火后高斯分峰拟合谱。 |
为减小缺陷能级的影响,对GaN/Si-NPA进行了氨气氛围高温退火。与退火前GaN/Si-NPA的PL谱相比,黄光缺陷发光峰强度大幅减弱。采用高斯分峰拟合后,可以将GaN/Si-NPA发光峰分为3个发光带(图 4(c)),分别为370.1 nm的紫外光带、420.0 nm的蓝光带、587.5 nm的黄光带。黄光带的减弱表明缺陷种类和浓度的降低,减少的缺陷种类为VGa、Ni。退火处理导致缺陷减少也表现在紫外光带相对光强增加,半高宽减小,峰值能量更接近于GaN的真实带隙。此外,蓝光带也出现了8.3 nm的蓝移,这是由于高温退火处理降低了Si-NPA中硅纳米晶的浅缺陷能级[17]。
2.3 GaN/Si-NPA的电学性能异质结中缺陷态的变化将导致其电学性能发生改变。图 5为GaN/Si-NPA的J-V特性曲线和双对数ln J-ln V曲线。如图 5(a)所示,GaN/Si-NPA异质结在退火前后均表现出很好的整流特性,但是退火处理导致其电学参数发生改变。在氨气氛围高温退火后,电流密度为5 mA/cm2的导通电压由2.7 V增加到3.8 V,-3 V偏压下的漏电流密度由5.1 mA/cm2减小到1.2 mA/cm2,电流密度为3 mA/cm2的反向击穿电压由2.1 V增加到4.6 V,5 V偏压下的正向电流密度由131.17 mA/cm2增加到151.23 mA/cm2,±5 V的整流比从10.2增加到41.7。如图 5(b)所示,将正向偏压下的J-V关系转换为双对数ln J-ln V图,可以更直接地分析不同偏压下载流子的输运机制。根据半导体异质结理论,电流-电压关系可以用指数函数J∝Vm来表示。当m<2时,载流子的输运满足欧姆定律;当m≥2时,电输运机制满足空间电荷限制电流(SCLC)模型,其中m=2(J∝V2)的理想情况表明所有的捕获态均被占据[18]。根据参数m的拟合值,退火前后GaN/Si-NPA异质结的ln J-ln V曲线均可分为3个线性区域:一个欧姆区域和两个SCLC区域。当外加偏压较低时,ln J-ln V关系对应于区域Ⅰ(退火前:V<0.82 V,m=1.13;退火后:V<1.37 V,m=1.23),载流子的输运遵循欧姆定律。随着外加偏压的增加,ln J-ln V关系对应于区域Ⅱ(退火前:0.82 V<V<2.63 V,m=2.12;退火后:1.37 V<V<4.27 V,m=2.37),载流子的输运满足SCLC模型且缺陷能级被部分填充。外加偏压继续增加,ln J-ln V关系对应于区域Ⅲ(退火前:V>2.63 V,m=5.06;退火后:V>4.27 V,m=17.67),缺陷能级被全部填充。

|
图 5 GaN/Si-NPA的J-V特性曲线和双对数ln J-ln V曲线 Fig. 5 The J-V characteristic curve and the double logarithmic ln J-ln V curve of GaN/Si-NPA |
GaN/Si-NPA的J-V特性曲线的变化情况表明,退火处理可以大大降低GaN/Si-NPA薄膜中的缺陷态密度,导致正向开启电压、正向电流密度、反向截止电压和整流比提高,漏电流密度降低。整流特性参数的优化将有利于GaN/Si-NPA基光电子器件性能的提高。
3 结论在催化剂铂的辅助作用下,以Si-NPA为功能性衬底采用化学气相沉积法制备了GaN/Si-NPA异质结,并在氨气氛围中对其进行了退火处理。测试结果表明,GaN/Si-NPA异质结中GaN呈六方纤锌矿结构,其PL谱由峰位位于384.5 nm的紫外光带、428.3 nm的蓝光带和577.1 nm的黄光带组成。经过氨气氛围高温退火后,XRD谱中衍射峰的半高宽减小,PL谱中与VGa、Ni相关的黄光缺陷发光峰强度和半高宽均大幅降低,表明退火处理在导致GaN晶粒尺寸增加的同时,显著降低了薄膜中VGa、Ni缺陷的种类和浓度。电学性能测试结果表明,退火处理在显著减小GaN/Si-NPA异质结漏电流密度的同时,开启电压、正向电流密度、反向截止电压和整流比均显著增加。上述结果表明,氨气氛围高温退火是提升GaN/Si-NPA异质结光电性能的一种有效手段。
| [1] |
CHEN K J, HABERLEN O, LIDOW A, et al. GaN-on-Si power technology: devices and applications[J]. IEEE transactions on electron devices, 2017, 64(3): 779-795. DOI:10.1109/TED.2017.2657579 (  0) 0) |
| [2] |
BI Z, BACON-BROWN D, DU F Y, et al. An InGaN/GaN MQWs solar cell improved by a surficial GaN nanostructure as light traps[J]. IEEE photonics technology letters, 2018, 30(1): 83-86. DOI:10.1109/LPT.2017.2775706 (  0) 0) |
| [3] |
JANI O, FERGUSON I, HONSBERG C, et al. Design and characterization of GaN/InGaN solar cells[J]. Applied physics letters, 2007, 91(13): 132117. DOI:10.1063/1.2793180 (  0) 0) |
| [4] |
ZHUO R R, WANG Y G, WU D, et al. High-performance self-powered deep ultraviolet photodetector based on MoS2/GaN p-n heterojunction[J]. Journal of materials chemistry C, 2018, 6(2): 299-303. DOI:10.1039/C7TC04754A (  0) 0) |
| [5] |
ZHUO R R, ZENG L H, YUAN H Y, et al. In-situ fabrication of PtSe2/GaN heterojunction for self-powered deep ultraviolet photodetector with ultrahigh current on/off ratio and detectivity[J]. Nano research, 2019, 12(1): 183-189. DOI:10.1007/s12274-018-2200-z (  0) 0) |
| [6] |
TAN J T, ZHANG S F, QIAN M C, et al. Effect of graphene/ZnO hybrid transparent electrode on characteristics of GaN light-emitting diodes[J]. Chinese physics B, 2018, 27(11): 552-558. (  0) 0) |
| [7] |
MENA J, CARVAJAL J J, MARTÍNEZ O, et al. Optical and structural characterisation of epitaxial nanoporous GaN grown by CVD[J]. Nanotechnology, 2017, 28(37): 375701. DOI:10.1088/1361-6528/aa7e9d (  0) 0) |
| [8] |
LI W S, NOMOTO K, LEE K, et al. Activation of buried p-GaN in MOCVD-regrown vertical structures[J]. Applied physics letters, 2018, 113(6): 062105. DOI:10.1063/1.5041879 (  0) 0) |
| [9] |
EHRENTRAUT D, KAGAMITANI Y, YOSHIKAWA A, et al. Ammonothermal synthesis of thick gallium nitride film employing acidic mineralizers[J]. Journal of materials science, 2008, 43(7): 2270-2275. DOI:10.1007/s10853-007-1949-3 (  0) 0) |
| [10] |
YU J D, HAO Z B, WANG J, et al. Study on AlN buffer layer for GaN on graphene/copper sheet grown by MBE at low growth temperature[J]. Journal of alloys and compounds, 2019, 783: 633-642. DOI:10.1016/j.jallcom.2019.01.007 (  0) 0) |
| [11] |
RESHCHIKOV M A, MORKOÇ H. Luminescence properties of defects in GaN[J]. Journal of applied physics, 2005, 97(6): 1301-1395. (  0) 0) |
| [12] |
UTAMA M I B, LU X, YUAN Y W, et al. Detrimental influence of catalyst seeding on the device properties of CVD-grown 2D layered materials: a case study on MoSe2[J]. Applied physics letters, 2014, 105(25): 253102. DOI:10.1063/1.4904945 (  0) 0) |
| [13] |
XU H J, LI X J. Silicon nanoporous pillar array: a silicon hierarchical structure with high light absorption and triple-band photoluminescence[J]. Optics express, 2008, 16(5): 2933-2941. DOI:10.1364/OE.16.002933 (  0) 0) |
| [14] |
SMITH M, LIN J Y, JIANG H X, et al. Room temperature intrinsic optical transition in GaN epilayers: the band-to-band versus excitonic transitions[J]. Applied physics letters, 1997, 71(5): 635-637. DOI:10.1063/1.119813 (  0) 0) |
| [15] |
ARMITAGE R, HONG W, YANG Q, et al. Contributions from gallium vacancies and carbon-related defects to the "yellow luminescence" in GaN[J]. Applied physics letters, 2003, 82(20): 3457-3459. DOI:10.1063/1.1578169 (  0) 0) |
| [16] |
IWATA H, KOBAYASHI H, KAMIYA T, et al. Annealing effect on threading dislocations in a GaN grown on Si substrate[J]. Journal of crystal growth, 2017, 468: 835-838. DOI:10.1016/j.jcrysgro.2017.01.001 (  0) 0) |
| [17] |
LI Y, WANG X B, FAN Z Q, et al. Temperature-dependent photoluminescence of silicon nanoporous pillar array[J]. Chinese physics letters, 2014, 31(4): 170-173. (  0) 0) |
| [18] |
LI Y, WANG L L, WANG X B, et al. Forward and reverse electron transport properties across a CdS/Si multi-interface nanoheterojunction[J]. Chinese physics B, 2014, 23(8): 502-507. (  0) 0) |
 2021, Vol. 53
2021, Vol. 53


